乲嘰乴丂婎斅幚憰乮傾僙儞僽儕丗慻棫乯偲俹倐僼儕乕偼傫偩愙崌
乮侾俉乯丂崅壏儕僼儘乕媦傃奜娤栤戣偲俹倐僼儕乕偼傫偩愙崌攋夡儌乕僪
乮侾俉亅侾乯丂崅壏儕僼儘乕栤戣
丂丂嫟徎俽値亅俹倐偺梈揰侾俉俁亷偵懳偟俹倐僼儕乕偼傫偩偺庡棳偺嫟徎嬤朤俽値俙倗俠倳偱偼梈揰偼俀俀侽亷嬤曈偲係侽亷嬤偔崅偔側偭偰偍傝丄
丂偦偺偨傔儕僼儘乕壏搙傕偐側傝崅偔側傝丄婎斅傗晹昳偵懳偟偰偺懴擬惈偺梫媮傕尩偟偔丄堦曽丄晹昳偺懴擬惈偺尷奅偐傜丄
丂僾儘僙僗丒僂傿儞僪僂乮儕僼儘乕壏搙斖埻乯偼彫偝偔側傝丄尩偟偄壏搙娗棟偑昁梫偲側傞丅
乮侾俉亅侾亅侾乯丂俹倐僼儕乕偼傫偩偺梈揰偲儕僼儘乕
丂丂亙奺庬偼傫偩偺梈揰亜
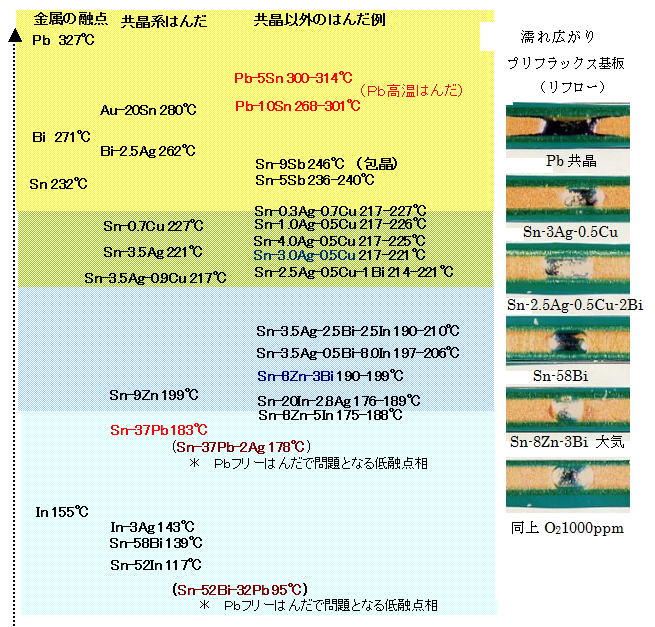

Frea倰

丂丂亙僾儘僙僗丒僂傿儞僪僂亜
俵俙俶俫俙俿俿俙俶寁夋丂俹倛倎倱倕侾丂俀侽侽俋


丂丂僾儘僙僗丒僂傿儞僪僂偑俹倐僼儕乕偱偼嫹傑傞丅
IBM

KURTZ


丂丂丂亙儕僼儘乕丒僾儘僼傽僀儖亜
俰俤俬俿俙
 丂
丂晉巑捠僥儞

丂丂亙僼儘乕乮僂僃乕償丄暚棳幃乯丒僾儘僼傽僀儖亜
墶壨

丂丂僾儕僸乕僩偐傜侾師暚棳傊偺堏峴帪偺壏搙掅壓傪梷惂偡傞丅
丂丂僂僃乕償偱偺俿俫晹昳偺婎斅棤昞偱偺壏搙嵎
俫倕値倠倕倢

俙倢倫倛倎亅俥倰倷

俿俬
丂僨傿僢僾丄僂僃乕償丄儕僼儘乕偺壏搙僾儘僼傽僀儖斾妑

俵俙俶俫俙俿俿俙俶寁夋丂俹倛倎倱倕侾丂俀侽侽俋
儕僼儘乕


婥憡偼傫偩晅偗

丂儗乕僓乕偼傫偩晅偗

乮侾俉亅侾亅俀乯丂婎斅偲晹昳偁傞偄偼僷僢働乕僕嵽椏偺懴擬惈
嘆丂夞楬婎斅嵽椏
丂亙俶俤俵俙婯奿亜
丂夞楬婎斅偺僌儗乕僪屇徧偼俶俤俵俙乮俙俶俽俬乯婯奿乮愊憌斅偺婯奿乯傪巊梡偡傞偺偑堦斒揑偱偁傞丅
丂俰俬俽傗俬俹俠丄俬俤俠丄俵俬俴丄俙俽俿俵丄俙俶俽俬側偳傕偁傝丄俙俽俿俵丄俙俶俽俬偼俶俤俵俙偲屇徧丒僌儗乕僪偼椶帡偟偰偄傞偑俰俬俽傗俬俹俠丄
俬俤俠丄俵俬俴偼慡偔堎側傞丅
丂俶俤俵俙婯奿偵偼億儕僀儈僪傗僼僢慺庽帀偺婯奿偼側偄丅
| 俶俤俵俙婯奿 | 婎嵽乮嫮壔嵽乯 | 庽帀 | 旛峫 |
| 倃丄倃倃丄倃倃倃 | 巻 | 僼僃僲乕儖 | 丒倃偑憹偊傞傎偳乮庽帀検懡偔側傝乯揹婥揑摿惈岦忋丄婡夿揑摿惈掅壓丅 丒屻晅偺俹偼擬娫懪敳壛岺惈丄俹俠偼椻娫懪敳壛岺惈傪堄枴偡傞丅 丒埨壙偱壛岺惈偑傛偄偑懴擱惈丄懴幖惈偵楎傞丅 丒怓偼墿妼怓偐傜妼怓丅 |
| 俤俽亅侾丄俀丄俁 | 巻 | 儊儔儈儞 | 丒俤俽亅侾丂昞柺亅崟丒奃丄恈亅敀 丒俤俽亅俀丂昞柺亅崟丒奃丄暃恈乮儊儔儈儞乯亅敀丄恈亅崟乮僼僃僲乕儖乯 丒俤俽亅俁丂昞柺亅敀丒奃丄恈亅崟乮僼僃僲乕儖乯 |
| 俠丄俠俤丄俠俥 | 僉儍儞償傽僗晍 | 僼僃僲乕儖 | 丒俠俤丄俴俤偼揹婥揑摿惈偱偦傟偧傟俠丄俴傛傝桪傟偰偄傞丅 丒俴丄俴俤偼揹婥揑摿惈丄媧幖惈偱俠丄俠俤傛傝桪傟偰偄傞丅 丒俠俥偼俠偺擄擱惈偺僌儗乕僪丅 丒怓偼崟丄墿妼怓丄愒丄墿怓丅 仏僉儍儞償傽僗canvas乮懢巺僐僢僩儞晍乯丄儕僱儞linen乮嵶巺僐僢僩儞晍乯 |
| 俴丄俴俤 | 儕僱儞晍 | ||
| 俧俀丄俧俁 | 僈儔僗晍 | 丒摨偠庽帀偱偼悢帤偑戝偒偔側傞傎偳摿惈偑傛偔側傞丅 丒俧俈乮僔儕僐儞宯乯偼僋儕乕儉怓偐敀怓丅俧俆丄俧俋乮儊儔儈儞宯乯偼奃怓偐傜妼怓丅 |
|
| 俧俆丄俧俋 | 儊儔儈儞 | ||
| 俧俈 | 僔儕僐儞 | ||
| 俧侾侽丄俧侾侾 | 僄億僉僔 | ||
| 乮俧俹倄乯 | 億儕僀儈僪 | 丒俙俶俽俬婯奿 | |
| N-1 | 僫僀儘儞晍 | 僼僃僲乕儖 | |
| 俥俼亅侾丄俀 | 巻 | 僼僃僲乕儖 | 丒倃倃倃俹俠偺擄擱惈偺僌儗乕僪丅 |
| 俥俼亅俁 | 僄億僉僔 | ||
| 俥俼亅係丄俆 | 僈儔僗晍 | 僄億僉僔 | 丒俧侾侽丄俧侾侾偺擄擱惈偺僌儗乕僪丅 丒怓偼墿怓偐傜椢怓丅 |
| 俥俼亅俇 | 僈儔僗晄怐晍 | 億儕僄僗僥儖 | |
| 俠俤俵侾丄俀 | 昞柺亅僈儔僗晍 恈亅巻 |
僄億僉僔 | 丒暋崌嵽 丒俠俤俵亅侾丄俁丄俠俼俵亅俆偑擄擱惈偺僌儗乕僪丅 |
| 俠俤俵俁丄係 | 昞柺亅僈儔僗晍 恈亅僈儔僗晄怐晍 |
||
| 俠俼俵俆丄俇 | 億儕僄僗僥儖 | ||
| 俧俹俷亅侾丄俀丆俁 | 僈儔僗晄怐晍 | 億儕僄僗僥儖 | 丒屻晅偺俹偼懪敳壛岺惈 丒擄擱惈 丒怓偼墿妼怓偐傜愒怓丅 |
丂丂俥俼丗flame rsistant
丂丂僈儔僗晍丗怐丄僋儘僗丄僈儔僗晄怐晍丗儅僢僩
丂仏俹俿俥俤庽帀偱偼僈儔僗晍婎嵽偱俧俿丄俧倃丄俧倄丄僈儔僗晄怐晍婎嵽偱俧俹丄俧俼偑俵俬俴偺屇徧丅
丂丂偦偺懠傾儔儈僪晄怐晍婎嵽偱僄億僉僔庽帀傗億儕僀儈僪庽帀乮IPC-4101/55丄IPC-4101/56乯
丂丂僈儔僗晍婎嵽偱偼俹俹俤庽帀乮IPC-4101/90:擄擱惈丄IPC-4101/91乯丄僔傾僱乕僩僄僗僥儖庽帀乮IPC-4101/70:擄擱惈丄
丂IPC-4101/71乯側偳偑偁傞丅
丂仏僾儕僾儗僌prepreg丗僈儔僗怐傗巻側偳偺婎嵽偵庽帀傪娷怹偝偣偨傕偺偱丄庽帀偼俛僗僥乕僕偲偄偆敿峝壔忬懺丅
丂丂丂丂丂丂丂丂丂丂丂丂丂丂捠忢僾儕僾儗僌傪僐傾嵽乮椉柺摵敁偺婎慴嵽乯丄摵敁偲愊憌偟壛擬丒壛埑惉宍偡傞偙偲偱愊憌斅laminate乮懡憌婎斅乯偑嶌惉偝傟傞丅
丂丂丂丂丂丂丂丂丂丂丂丂丂丂愊憌斅laminate偺嬫暿丒暘椶偲偟偰婎嵽乮巻丄晄怐僈儔僗慇堐丄怐僈儔僗慇堐側偳乯偲庽帀乮僼僃僲乕儖庽帀丄
丂丂丂丂丂丂丂丂丂丂丂丂丂丂僄億僉僔庽帀側偳乯偑巊梡偝傟傞偨傔僾儕僾儗僌偲愊憌斅偺嬫暿偑偁偄傑偄偲側偭偰偄傞丅
丂仏俹俠俛丄俹倂俛丄俹俠俙丄俠俠俙
丂丂丂僾儕儞僩攝慄斅俹倂俛乮printed wiring board乯丗晹昳搵嵹乮幚憰丄傾僙儞僽儕乯慜偺惗偺婎斅
丂丂丂僾儕儞僩夞楬婎斅俹俠俛乮printed circuit board乯丗晹昳搵嵹屻偺婎斅丄俹俠俙丄俠俠俙傕摨條丅
丂丂丂俹俠俙乮printed circuit assembly乯
丂丂丂俠俠俙乮circuit card assembly乯丗旕岞幃偱偼俹俠俛偼惗丄傾僙儞僽儕椉曽偺婎斅偵巊梡偝傟傞偺偱俬俹俠偼俠俠俙傪岲傓丅
丂亙戙昞揑僌儗乕僪偺婯奿懳徠亜
俹倎値倎倱倧値倝們

揹巕忣曬捠怣妛夛抦幆儀乕僗


丂亙庡側庽帀偺摿惈亜
俙俵俬丏俙俠


丂亙俛俿儗僕儞亜
埢栰
丂俛俿儗僕儞丗僩儕傾僕儞儌僲儅乕偲價僗儅儗僀儈僪偐傜崌惉偝傟傞僩儕傾僕儞娐偲僀儈僪娐峔憿傪傕偮億儕僀儈僪庽帀丅



嬥尨
丂丂僄億僉僔曄惈俛俿儗僕儞

丂丂俛俿儗僕儞乮俠俠俴亅俫俴倶倶倶乯乯偺摿惈

丂亙愊憌嵽偺峔憿亜
杮廈惢巻


丂僈儔僗晄怐晍偲僈儔僗晍
 丂丂
丂丂
丂僈儔僗丒儅僢僩乮晄怐晍乯丗奜娤丂丂丂丂僈儔僗晍乮俶倧乯
倀俶俬亅俷俛倀俢俙

 丂
丂丂丂忋偐傜儗僕僗僩丄攝慄丄愊憌斅乮僈儔僗晍嫮壔乯
NITE

俹倎値倎倱倧値倝們

俷倱倢倧戝

丂亙僜儖僟儗僕僗僩乮僜儖僟儅僗僋乯亜
堫奯
丂丂僜儖僟儗僕僗僩偺拝怓
丂丂丂丂椢怓丗僼僞儘僔僯傾儞
丂丂丂丂丂丂僴儘僎儞僼儕乕壔偱惵怓仺俀怓偺婄椏偱椢怓壔

丂亙俹倐僼儕乕偲婎斅偺晄椙亜
俢倖俼丂俀侽侽俆

嘇丂晹昳偁傞偄偼僷僢働乕僕嵽椏
IBM
丂丂丒懴擬惈偑栤戣偲側傝傗偡偄晹昳丂丒丒丒昞柺幚憰晹昳俽俵俢

丂丂丂丂傾儖儈僯僂儉揹夝僉儍僷僔僞丄僞儞僞儖揹夝僉儍僷僔僞丒丒丒揹夝塼偲偦偺晻巭丄儌乕儖僪庽帀側偳
丂丂丂丂僼傿儖儉僉儍僷僔僞
丂丂丂丂僼乕僘
丂丂丂丂僀儞僟僋僞丄儚僀儎丒僐僀儖
丂丂丂丂旕屌懱儕儗乕
丂丂丂丂俴俤俢
丂丂丂丂俽俵俿僐僱僋僞
丂丂丂丂揹婥俀廳憌僉儍僷僔僞

倁倝倱倲倕倧値

丂丂丂懴擬惈偵拲堄偑昁梫側晹昳乮俽俵俢乯
丂丂丂丂丂丂丂揹夝僉儍僷僔僞
丂丂丂丂丂丂丂僀儞僟僋僞
丂丂丂丂丂丂丂儗僝僱乕僞乕
丂丂丂丂丂丂丂悈徎怳摦巕
TYCO
丂丂崅暘巕偺擬惈擻丂
丂丂丂揟宆揑僄儞僕僯傾儕儞僌
丂丂丂丂擬壜慪惈僾儔僗僠僢僋偺擬曄宍壏搙俫俢俿

丂俹俛俿丗億儕僽僠儗儞僥儗僼僞儗乕僩
丂俹俹俤丗億儕僼僃僯儗儞僄乕僥儖
丂俹俙丗億儕傾儈僪
丂俽俹俽丗僔儞僕僆僞僋僠僢僋億儕僗僠儗儞
丂俹俹俽丗億儕僼僃僯儗儞僒儖僼傽僀僪
丂俹俹俙丗億儕僼僞儖傾儈僪
丂俹俠俿丗億儕僔僋儘傊僉僔儗儞僕儊僠儗儞僥儗僼僞儗乕僩
丂俴俠俹丗塼徎億儕僄僗僥儖

僄儞僾儔媄弍楢崌夛
丂擬壜慪惈庽帀
丂丂僗乕僷乕僄儞僾儔
丂丂丂丒億儕僼僃僯儗儞僒儖僼傽僀僪乮俹俹俽乯
丂丂丂丒億儕傾儕儗乕僩乮俹俙俼乯
丂丂丂丒億儕僗儖儂儞乮俹俽倀丄俹俽俥乯
丂丂丂丒億儕僄乕僥儖僗儖儂儞乮俹俤俽乯
丂丂丂丒億儕僄乕僥儖僀儈僪乮俹俤俬乯仺擬壜慪惈億儕僀儈僪乮俿俹俬乯
丂丂丂丒億儕傾儈僪僀儈僪乮俹俙俬乯
丂丂丂丒億儕僄乕僥儖僄乕僥儖働僩儞乮俹俤俤俲乯
丂丂丂丒塼徎億儕儅乕乮俴俠俹乯丂仺慡朏崄懓億儕僄僗僥儖
丂丂丂丂丂乮億儕僆僉僔儀儞僝僀儖俹俷俛乯
丂丂斈梡僄儞僾儔
丂丂丂丒億儕傾儈僪乮俹俙乯
丂丂丂丒億儕僇乕儃僱乕僩乮俹俠乯
丂丂丂丒億儕傾僙僞乕儖乮俹俷俵乯
丂丂丂丒曄惈億儕僼僃僯儗儞僄乕僥儖乮倣亅俹俹俤乯
丂丂丂丒僈儔僗慇堐嫮壔俹俤俿
丂丂丂丒僼僢慺庽帀
丂擬峝壔庽帀
丂丂丂丒僼僃僲乕儖庽帀
丂丂丂丒擜慺庽帀
丂丂丂丒儊儔儈儞庽帀
丂丂丂丒傾儖僉僪庽帀
丂丂丂丒晄朞榓億儕僄僗僥儖
丂丂丂丒億儕僂儗僞儞
丂丂丂丒僔傾僱乕僩庽帀
丂丂丂丒僄億僉僔庽帀
丂丂丂丒僕傾儕儖僼僞儗乕僩俢俙俹
丂丂丂丒僔儕僐乕儞庽帀
丂丂丂丒擬峝壔惈億儕僀儈僪仺價僗儅儗僀儈僪丄俛俿儗僕儞
丂丂揹巕晹昳僷僢働乕僕偺惉宍曽朄
丂丂丒僩儔儞僗僼傽乕乮堏憲乯朄丗庡偵俛僗僥乕僕忬懺偺擬峝壔惈庽帀丄億僢僩晹偱庽帀僞僽儗僢僩傪梟梈偝偣儔儞僫乕丒僎乕僩
丂丂偲徧偡傞捠楬傪捠偟偰僾儔儞僕儍偱嬥宆偺僉儍價僥傿乮嬻娫乯偵墴偟崬傓丅俬俠偺戙昞揑惉宍朄丅
搶幣

丂丂丒僐儞僾儗僢僔儑儞乮埑弅乯朄丗梟梈偟偨庽帀偵怹捫偟壛埑丅
俿俷倂俙

丂丂丒僀儞僕僃僋僔儑儞乮幩弌乯朄丗庡偵擬壜慪惈庽帀偺儂僢僩儊儖僩朄丄梟梈偟偨庽帀傪僗僋儕儏乕偱宆偵墴偟崬傓丅
俲俢俙

丂丂丒億僢僥傿儞僌乮乮拲擖乯丗働乕僗乮梕婍乯偵塼忬偺庽帀傪拲擖偟峝壔偝偣傞丅俀塼惈庽帀側偳丅俬俠偱偼棙梡偝傟側偄丅
徏塰揹岺

| 栠丂傞 | 栚丂師 | 師丂傊 |